【1】最終テストとは何か
最終テスト(Final Test)は、完成した半導体チップやパッケージが、仕様どおりに動作するかを最終確認する工程。
不良を見逃すと、車載、安全機器、サーバなどで重大事故につながるため、
製品出荷の最終ゲート として非常に重要。
最終テストには2種類ある:
● E-Test(Wafer Test / ウェハプローブ)
● FT(Final Test / パッケージ後テスト)
【2】E-Test(Wafer Test)とは
ウェハ上で個々のチップにプローブ針を当てるテスト。
●目的
・ チップの電気的基本特性を測定
・ 不良チップを選別(KGD:Known Good Die の確保)
・ 製造プロセスの品質フィードバック
●主な測定項目
・ トランジスタの特性(Id-Vg、リーク)
・ 抵抗値、容量
・ 発振テスト
・ メモリビットの基本動作
・ スピードパス(タイミング)
●使用機器
・ ウェハプローバ(Probe Station)
・ テスター(ATE:Automatic Test Equipment)
・ 高倍率カメラ/アライメントシステム
E-Testで不良を排除することで、後工程の無駄なコストを抑えることができる。
【3】FT(Final Test)とは
パッケージ完成後の最終検査。
●目的
・ 出荷レベルの性能確認
・ I/Oの接続確認
・ 熱・電気ストレスに対する信頼性確認
・ 車載規格(AEC-Q100など)への適合
●主な測定項目
・ 高速I/O(PCIe、DDR、SerDes)
・ 消費電力(電源特性)
・ クロック速度(最大周波数)
・ 機能テスト(ロジック動作、メモリ動作)
・ 温度サイクルでの安定性
・ バーンイン(加速試験)
特にAIサーバ用GPUや高速メモリでは、熱試験・ストレス試験が必須。
【4】バーンイン(Burn-in)試験
最も重要な信頼性試験のひとつ。
●バーンインとは
高温・高電圧などのストレス環境で一定時間動作させ、
初期故障(Infant Mortality)を検出する試験。
●なぜ重要か
半導体故障は「バスタブ曲線」で説明され、
初期故障期に不良が多発するため、
出荷前に潰しておく必要がある。
【5】検査自動化とAI活用
近年、テスト量が爆発的に増加(特にAI半導体)。
そのため:
● テストプログラムの自動生成
● データ解析によるパス/フェイル判定
● 画像AIによるプローブマーク判定
● 不具合因果をAIが推定するツール
などが急速に普及している。
テスト工程は今後、AI主導の品質保証 へ移行していくと予測される。
【6】テストコストと歩留まりへの影響
テストは工程の中でもコストが高い。
理由は:
● 高価なATE装置(1台 数億〜数十億円)
● 時間あたりテスト量に制限がある
● 消費電力上昇により高負荷テストが増えた
● メモリ容量の増大でテスト時間が伸びている
したがって、テスト効率の改善は歩留まり改善と利益率の鍵 となる。
【7】最新トレンド
● チップレット化によるテスト工程の複雑化
● 3Dパッケージ(HBM)の温度テスト需要増
● 低電圧化により測定精度が重要に
● マルチサイト・並列テストの技術向上
● 高速通信規格(112Gbps級)のテスト装置進化
● ウェハレベルバーンインの研究
特にAIデバイスは発熱が大きく、温度+電気的ストレスの複合テストが必須 になっている。
【8】まとめ
● E-Test はウェハ段階の基本特性検査
● FT はパッケージ後の最終出荷テスト
● バーンインは初期故障の検出に必須
● テストは装置・時間が高コストな工程
● AI × テストデータ解析が必須の時代へ
【理解チェック|4-13】
1.E-Test と Final Test の最大の違いは?
2.バーンイン試験が必要な理由を説明してください。
3.テスト工程が「高コスト」と言われる理由を2つ挙げてください。
コラム監修:角本 康司 (オーティス株式会社)
語学留学や商社での企画開発を経て2011年にオーティス株式会社入社。経営企画部を中心に製造・技術部門も兼任し、2018年より代表取締役として事業成長と組織強化に努めている。
※本記事は教育・啓発を目的とした一般的な技術解説であり、特定企業・製品・技術を示すものではありません。

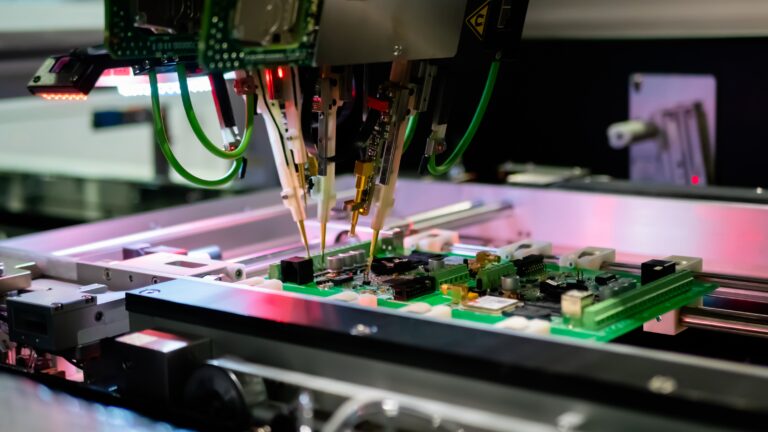


![[半導体シリーズ] Vol.3/4 ― 半導体産業を支える技術と仕組み<br>検査・サプライチェーン・環境への取り組み](https://otis-group.com/wp-content/uploads/2025/12/column_251229-1024x576.jpeg)