【1】成膜工程とは
成膜(Deposition)は、
ウェハ表面に薄い膜(薄膜)を形成する工程 の総称。
形成する膜の種類は多岐にわたり:
● 絶縁膜(SiO₂、SiN、Low-k)
● 金属膜(Cu、Al、Ti、W)
● バリア膜(TiN、TaN)
● ゲート材料(W、HfO₂)
● 保護膜(SiN)
半導体プロセスでは、必要なところに必要な膜を、必要な厚さと品質で作る
ことがデバイス性能を支える。
【2】成膜方式の分類
成膜方式は大きく以下の2つに分かれる。
(1)CVD(Chemical Vapor Deposition)
気体の原料ガスを化学反応させて膜を堆積させる方式。
(2)PVD(Physical Vapor Deposition)
物理的手法で材料を蒸発・飛ばして膜を形成する方式。
この区別が理解できれば、成膜の基礎はつかめる。
【3】CVD成膜の種類と特徴
CVDは以下の方式に分類される。
LPCVD(Low Pressure CVD)
● 低圧で膜の均一性が高い
● ポリシリコン、SiN膜などに使用
● 高温(600〜800°C)
PECVD(Plasma Enhanced CVD)
● プラズマを使うことで低温成膜が可能(300〜400°C)
● BEOLやパッシベーション膜に多用
● 低温でガラス基板や多層構造にも対応
MOCVD(Metal-Organic CVD)
● GaN、LED、化合物半導体で必須のプロセス
● AlGaN/GaN HEMT などのエピ膜成長に利用
ALD(Atomic Layer Deposition)
● 原子1層ずつ積む“究極の薄膜制御”
● High-kゲート、3D構造のバリア膜に必須
● 膜厚の原子レベル制御が可能
微細化が進むほど、
ALDとMOCVDの重要性が増している。
【4】PVD成膜の種類
■ スパッタリング(Sputtering)
● イオンでターゲット(金属)を叩き出し膜を形成
● Cu、Ti、TiN、Alなど配線・バリア膜に使用
● 比較的低温で高速
■ 蒸着(Evaporation)
● 加熱して材料を蒸発させ、ウェハに付着
● 研究用途や特定の金属膜で利用
● 工業量産ではスパッタの方が主流
【5】成膜工程で重要な膜特性
形成される薄膜には、以下が求められる。
● 膜厚均一性(Across wafer uniformity)
● 密度(高密度=高信頼性)
● ステップカバレッジ
● バリア性(CuがSiに侵入しないように)
● 誘電率(Low-k化で遅延を低減)
● 機械的強度・ストレス
特に、微細配線では
Low-k材料(低誘電率絶縁膜) が重要。
理由:配線のRC遅延を減らし、動作速度を向上するため。
【6】用途別の典型的な成膜材料
用途ごとに代表材料は次の通り。
絶縁膜
● SiO₂
● SiN
● Low-k材料(SiOC、SiOF)
金属配線
● Cu(銅)
● Al
● W(タングステン)(コンタクト材料)
バリア膜
● TiN
● TaN
● Mn系バリア(次世代)
ゲート材料
● 高k材料(HfO₂)
● 金属ゲート(TiN、W)
配線が微細化するほど、
バリア膜と低誘電率膜の技術が鍵になる。
【7】成膜工程の課題と最新動向
■ 3D構造への対応
FinFET → GAA → 3D NAND
と構造が複雑化するにつれ、
側壁に均一に膜をつける ALDが必須に。
- バリアフリー配線の研究
■ Cu配線の限界により、
- Ru
- Co
- グラフェンバリア
の研究が進んでいる。
■ Low-k材料の機械強度問題
低誘電率化すると脆くなるため、
ストレス制御やハイブリッド材料が課題。
【8】まとめ
● 成膜は薄膜を作る核心工程で、CVD・PVDの2つが基本
● 微細化が進むほどALDが重要
● 材料は用途ごとに明確に使い分ける
● 配線、小型化、3D化で成膜技術の重要度は高まる
● バリア膜、Low-k膜は未来の配線速度を左右する
【理解チェック】
1.CVDとPVDの違いを説明してください。
2.ALDが重要になっている理由は?
3.Low-k材料が使われる目的は?
コラム監修:角本 康司 (オーティス株式会社)
語学留学や商社での企画開発を経て2011年にオーティス株式会社入社。経営企画部を中心に製造・技術部門も兼任し、2018年より代表取締役として事業成長と組織強化に努めている。
※本記事は教育・啓発を目的とした一般的な技術解説であり、特定企業・製品・技術を示すものではありません。

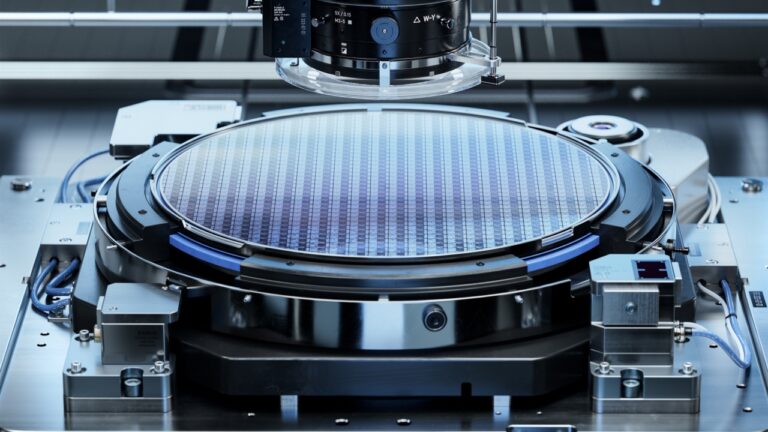


![[半導体シリーズ] Vol.3/4 ― 半導体産業を支える技術と仕組み<br>検査・サプライチェーン・環境への取り組み](https://otis-group.com/wp-content/uploads/2025/12/column_251229-1024x576.jpeg)