【1】CMPとは何か
CMP(Chemical Mechanical Polishing)とは、
化学反応(Chemical)と機械的研磨(Mechanical)を組み合わせて、ウェハ表面を平坦化する工程。
現代の半導体製造では、この平坦化が 配線精度・歩留まり・速度・信頼性 を決める非常に重要なプロセス。
【2】CMPが必要になる理由
半導体は多層構造で作られる。
● トランジスタ層
● 絶縁層
● 配線層(10層以上)
● さらに上層の絶縁膜
これを積み重ねると、表面は凹凸だらけになる。
凹凸が残ると:
● リソグラフィでフォーカスが合わない
● エッチング精度が低下
● 配線の太さ・抵抗がばらつく
● 信頼性不良が増える
そのため 層ごとに完全に平らに戻す 必要がある。
これを実現するのが CMP。
【3】CMPの基本メカニズム
CMPは以下の3つの要素で成り立つ。
●(1)スラリー(Slurry)
化学薬品+研磨粒子(アルミナ、シリカなど)。
・化学反応で膜を軟化
・研磨粒子で削る
この 化学+機械 のハイブリッドがポイント
●(2)パッド(研磨布)
ウェハを押し付けて削るための消耗部材。
・固さや表面構造で研磨性能が変わる
・定期的なコンディショニングが必要
●(3)圧力+回転(Polishing)
ウェハとパッドを回転させつつ、圧力をかけることで均一に削る。
【4】CMPの用途
CMPは半導体のあらゆる工程で利用される。
●(1) STI(Shallow Trench Isolation)
浅い溝を酸化膜で埋めたあと、余分な膜を削って平坦化。
●(2)ゲート形成(金属ゲートCMP)
ゲートスタックを形成後、余分な材料を除去。
●(3)多層Cu配線
Cu配線はダマシン法で形成するため、CMPは必須。
・Cu CMP
・バリア膜(Ta/TaN)CMP
・ILD(絶縁膜)CMP
・比抵抗低減や表面粗さ制御にも関わる
【5】CMPで重要な指標(KPI)
CMPは削りすぎや削らなすぎが致命的になるため、
細かい制御が求められる。
代表的なKPI:
● レート(Removal Rate):削る速度
● 均一性(Uniformity):ウェハ内でのばらつき
● スクラッチ欠陥:研磨傷の発生
● ディッシング(Dishing):Cuだけ凹む現象
● エロージョン(Erosion):絶縁膜も削られて凹む現象
● 残渣(Residue):膜が残る不良
特にディッシングとエロージョンは、
配線抵抗が増えたり信頼性劣化につながる。
【6】ダマシンプロセスとCMPの関係
Cu配線は ダマシン法 で形成する。
手順は以下:
1.絶縁膜に溝をエッチング
2.バリア膜・Cuを全面に成膜
3.CMPで溝以外のCuを削って配線だけ残す
つまり、
Cu配線はCMPで作るとも言えるほど密接な関係がある。
CMPなしでは現代の多層配線は成立しない。
【7】CMPの難しさと工程管理
CMPは以下の点で難しいプロセスとされる。
● 化学反応と機械研磨の複雑な相互作用
● 3D構造での均一研磨
● 配線密度によって削れ方が変わる(密度依存性)
● スラリーの劣化や供給条件
● パッドのコンディション
● ウェハ内の局所的な圧力分布
そのため、材料科学 × 機械制御 × 流体制御 × プロセス最適化の総合力が求められる。
【8】CMPの最新動向
現代の先端プロセスでは、以下の技術が中心。
● モノレイヤーポリッシング(極薄層の精密除去)
● Cu再配線向けHFフリーCMPスラリー
● 3D NANDの多層平坦化CMP
● AI制御によるリアルタイム最適化
● パッド自動診断(画像・音響解析)
● 低ダメージCMP(低ストレス研磨)
今後も材料+データ+AIによる進化が続く。
【9】まとめ
● CMPは表面を平坦化する重要工程
● 化学反応+機械研磨のハイブリッド方式
● Cu配線やSTIなど、ほぼ全工程で使用
● ディッシング・エロージョンが主要課題
● CMP精度が歩留まりと信頼性を左右する
● AI・センシング技術による進化が加速中
【理解チェック】
1.CMPの目的は何ですか?
2.CMPが必須となる代表的な用途を1つ挙げてください。
3.CMPで発生する代表的な欠陥を1つ挙げてください。
コラム監修:角本 康司 (オーティス株式会社)
語学留学や商社での企画開発を経て2011年にオーティス株式会社入社。経営企画部を中心に製造・技術部門も兼任し、2018年より代表取締役として事業成長と組織強化に努めている。
※本記事は教育・啓発を目的とした一般的な技術解説であり、特定企業・製品・技術を示すものではありません。

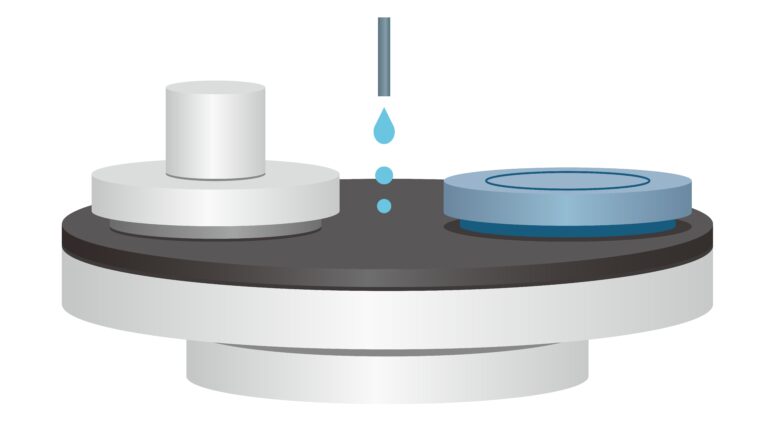


![[半導体シリーズ] Vol.3/4 ― 半導体産業を支える技術と仕組み<br>検査・サプライチェーン・環境への取り組み](https://otis-group.com/wp-content/uploads/2025/12/column_251229-1024x576.jpeg)